パワーデバイス(SiC, GaN)向け
蛍光検査装置 INSPECTRA® PLシリーズ
Luminescence Defect Inspection System "INSPECTRA® PL" Series for Power devices (GaN, SiC)
PL(フォトルミネッセンス)を用いて可視光外観検査では見えなかった結晶欠陥・クラック・発光不良を自動検査
<概要>
PL(フォトルミネッセンス)による蛍光画像を用いて従来の可視光外観検査では見えなかった結晶欠陥・クラック・発光不良を高速・高感度に自動検査します。
<特長>
- 独自の光学系と検査アルゴリズムにより高速・高感度で結晶欠陥の検出・分類を行います。
- ウェーハ外観検査装置にオプションにて搭載することにより、EPI工程での結晶欠陥検査だけでなく、パターン工程の外観検査まで試作・量産における一貫した検査に適用可能です。
- 可視光検査とPL検査を組み合わせることで、キラー欠陥が特定でき、歩留まり改善に貢献します。
<仕様>
| GaN |   |
  |
|
| SiC |  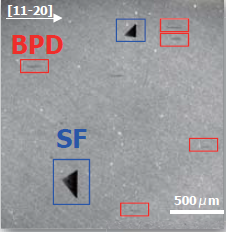 |
 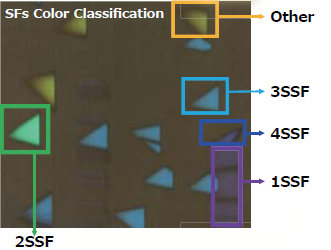 |
|
  |
 |
  |
<SiC用途(パワーデバイス)>
| 対象サンプル | SiCウェーハ、チップ |
|---|---|
| 画素分解能 | 0.325um~ |
| 検査速度 | 15分(4 inchウェーハ 5x PL検査時) |
| 対応ウェーハサイズ | 2~8inch |
| ターゲット欠陥 | 基底面転位(BPD)、積層欠陥(SF)等の結晶欠陥、パターン外観不良等 |
<GaN用途(パワーデバイス)>
| 対象サンプル | GaN/サファイア、GaN/SiC、GaN/Si、GaN/GaNウェーハ、チップ |
|---|---|
| 画素分解能 | 0.325um~ |
| 検査速度 | 15分(4 inchウェーハ 5x PL検査時) |
| 対応ウェーハサイズ | 2~8inch |
| ターゲット欠陥 | 結晶欠陥、クラック、パターン外観不良等 |
お問い合わせ先
- お問い合わせ
-
瀬田事業所 : (077)544-1635