光学式半導体ウェーハ外観検査装置
INSPECTRA®シリーズ
Wafer Inspection System "INSPECTRA®" Series
ウェーハ外観検査装置
<概要>
業界最高速
半導体製造の前工程から後工程まで『ハイスピード』『ハイスペック』でウェーハの全数自動検査の要求にお応えします。
INSPECTRA®シリーズは、高速・高感度で全数検査を実現可能としたウェーハ外観検査装置です。
当社独自の「良品学習アルゴリズム(DSI比較法)」により、プロセスの変動要因を吸収し、擬似欠陥の発生を抑え、ターゲットとする欠陥のみを検出することが可能です。
<ラインナップ>
SR-Ⅳシリーズは従来機種の機能性に加えて、検査性能の向上、装置信頼性とユーザビリティも改善させたハイグレードモデルです。
高倍率検査では従来品「INSPECTRA SR-Ⅲ」比で検査速度を約2倍実現させました。
高精度・高速検査を実現したSR-Ⅳ・SR-Ⅲシリーズ、ダイシング後ウェーハ検査が可能なFR-Ⅲシリーズなど、幅広いラインナップでお客さまのご要望に対応いたします。
<仕様>
| 欠陥検出事例 | 微分干渉光学系/DIC 内部クラック検出事例 |
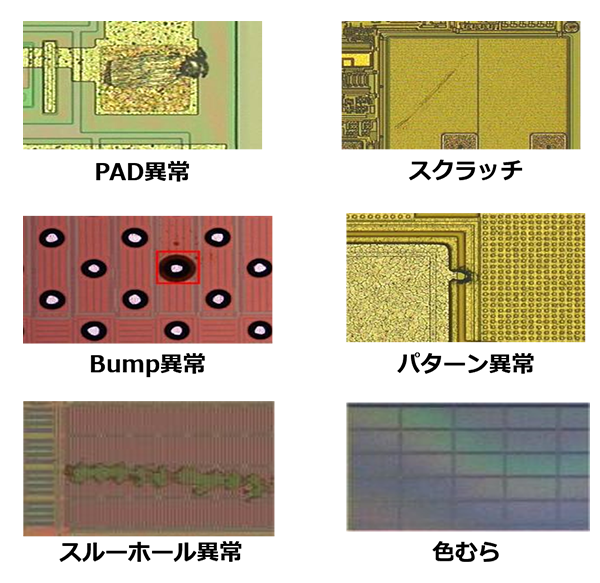 INSPECTRAシリーズ |
 FR-Ⅲシリーズ |
ウェーハ外観検査装置 INSPECTRA®シリーズ ラインナップ
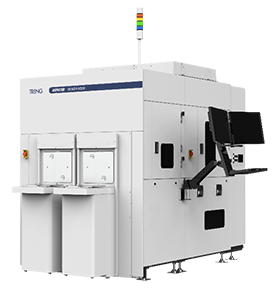
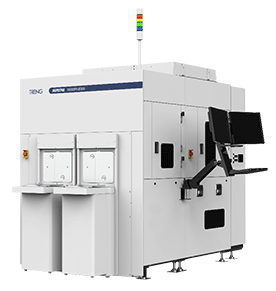
| シリーズ | 装置特長 | ワークサイズ |
|---|---|---|
| SR-Ⅳシリーズ | 高倍率検査の検査速度は従来品「INSPECTRA SR-Ⅲ」比で約2倍進化。 市場ニーズに合わせた高精度な検査と高速での全数検査の両立を実現。 |
2~12 inch |
| SR-Ⅲシリーズ | SRシリーズの後継機種。 要求感度での全数検査でプロセスをモニタリングすることにより、早期に不良流出防止を突き止めることが可能。 |

| シリーズ | 装置特長 | テープフレームサイズ |
|---|---|---|
| FR-Ⅲシリーズ | ダイシング後、エキスパンド後の検査に最適。 テープフレーム自動搬送。 |
~400mm |
| 便利な標準機能 | 感度シミュレーション、PAD検査、欠陥カラー画像保存、ノンパターン検査、Cell to Cell検査、Die to Die検査、自動欠陥分類、全画像保存、アクティブオートフォーカス、イオナイザー、レシピ共有化、照明キャリブレーション、チップ回転、位置ズレ補正(FRシリーズ)他 |
|---|---|
| 豊富なオプション | 微分干渉光学系、斜光照明、ウェーハ裏面・エッジ検査、結果解析機能、ウェーハクリーナ、測長機能、カラー検査、AI-ADC機能(AIによる欠陥分類機能)、各種ウェーハ搬送対応(薄化/反り/基板)、各種通信対応、各種データ出力対応、他 |
| 実績例 | 各種LSI、CIS、MEMS、LED、バンプ・TSV・Via検査、パワー半導体、SiC、GaN、化合物半導体 |
お問い合わせ先
- お問い合わせ
-
瀬田事業所 : (077)544-1635